场效应管MOSFET选型与应用
场效应管也称单极型晶体管,是利用电场效应控制半导体中多数载流子运动的一种半导体开关器件。
它具有输入阻抗高、动态范围宽、热稳定性好、抗辐射能力强、制造工艺简单、有利于大规模集成等优点。
按其结构和工作原理不同可分为绝缘栅场效应管和结型场效应管两种类型。常用绝缘栅场效应管是由金属、氧化物(SiO2 或SiN)及半导体三种材料制成的器件,也称为金属-氧化物-半导体场效应管(Metal Oxide Semiconductor Field Effect Transistor) ,即 MOSFET。
基本结构
MOSFET 的结构以N 沟道增强型为例,N 沟道增强型MOSFET 结构剖面图如图1 所示。它以一块掺杂浓度较低,电阻率较高的P 型硅半导体薄片作为衬底,利
用扩散的方法在P 型硅中形成两个高掺杂的N+区。然后在P 型硅表明生成一层很薄的二氧化硅绝缘层,并在二氧化硅表面以及N+型区的表面上分别引出三个电极—栅极G、漏极D、源极S,就构成了N 沟道MOSFET。
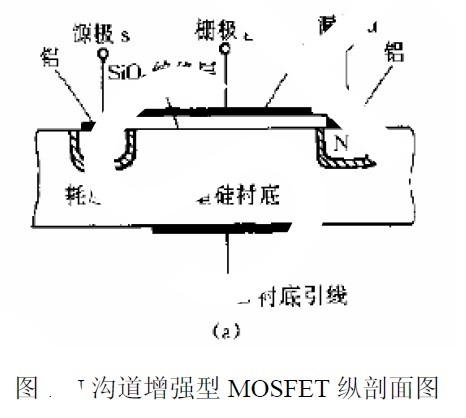
由于栅极与源极、漏极均无电接触,故称绝缘栅极。其他类型的MOSFET结构与N沟道增强型相类似。场效应管通常制成漏极和源极可以互换,而V-I特性曲线没有明显变化。为了减轻源衬间电压对管子导电性能的影响,通常将衬底与源极相连,此时不能将漏极和源极对调使用。按MOSFET内沟道导电类型的不同,分为N沟道和P沟道两种。按其栅偏压为零时有无沟道形成,又可分成耗尽型与增强型。此外,按MOSFET导电沟道结构,还可以分为平面式和垂直式MOSFET,垂直式又包括V-MOSFET,T-MOSFET和U-MOSFET等。 耗尽型与增强型主要区别在于制造SiO2绝缘层中是否掺入大量的带电离子。以N型耗尽型MOSFET为例,SiO2绝缘层中掺有大量的碱金属正离子(如Na+或K+),使在P型衬底的界面上感应出N型薄层,即在两个N型区中间的P型硅内形成N型导电沟道,所以在VGS=0时,有VDS作用时也有一定的电流IDSS;当存在栅偏压(正电压或负电压)时,相应改变感应的电子数量或正电荷,从而改变N沟道厚度,使改变ID的大小。VP为ID=0时的VGS,称为夹断电压。

场效应管的参数很多,一般datasheet都包含如下关键参数:
极限参数:
ID:最大漏源电流。是指场效应管正常工作时,漏源间所允许通过的最大电流。场效应管的工作电流不应超过ID。此参数会随结温度的上升而有所减额。 IDM:最大脉冲漏源电流。此参数会随结温度的上升而有所减额。
PD:最大耗散功率。是指场效应管性能不变坏时所允许的最大漏源耗散功率。使用时,场效应管实际功耗应小于PDSM并留有一定余量。此参数一般会随结温度的上升而有所减额。
VGS:最大栅源电压。
Tj:最大工作结温。通常为150℃或175℃,器件设计的工作条件下须确应避免超过这个温度,并留有一定裕量。
TSTG:存储温度范围。
静态参数
V(BR)DSS :漏源击穿电压。是指栅源电压VGS为0时,场效应管正常工作所能承受的最大漏源电压。这是一项极限参数,加在场效应管上的工作电压必须小于V(BR)DSS。它具有正温度特性。故应以此参数在低温条件下的值作为安全考虑。
△ V(BR)DSS/△Tj:漏源击穿电压的温度系数,一般为0.1V/℃。
RDS(on):在特定的VGS(一般为10V)、结温及漏极电流的条件下,MOSFET导通时漏源间的最大阻抗。它是一个非常重要的参数,决定了MOSFET导通时的消耗功率。此参数一般会随结温度的上升而有所增大。故应以此参数在最高工作结温条件下的值作为损耗及压降计算。
VGS(th):开启电压(阀值电压)。当外加栅极控制电压VGS超过VGS(th)时,漏区和源区的表面反型层形成了连接的沟道。应用中,常将漏极短接条件下ID等于1毫安时的栅极电压称为开启电压。此参数一般会随结温度的上升而有所降低。
IDSS :饱和漏源电流,栅极电压VGS=0、VDS为一定值时的漏源电流。一般在微安级。
IGSS :栅源驱动电流或反向电流。由于MOSFET输入阻抗很大,IGSS一般在纳安级。
动态参数
gfs:跨导。是指漏极输出电流的变化量与栅源电压变化量之比,是栅源电压对漏极电流控制能力大小的量度。gfs与VGS的转移关系图如图2所示。
Qg:栅极总充电电量。MOSFET是电压型驱动器件,驱动的过程就是栅极电压的建立过程,这是通过对栅源及栅漏之间的电容充电来实现的,下面将有此方面的详细论述。
Qgs:栅源充电电量。
Qgd:栅漏充电(考虑到Miller效应)电量。
Td(on):导通延迟时间。从有输入电压上升到10%开始到VDS下降到其幅值90%的时间(参考图4)。
Tr:上升时间。输出电压VDS从90%下降到其幅值10%的时间。
Td(off):关断延迟时间。输入电压下降到90%开始到VDS上升到其关断电压时10%的时间。
Tf:下降时间。输出电压VDS从10%上升到其幅值90%的时间(参考图4)。
Ciss:输入电容,Ciss= CGD + CGS ( CDS短路)。
Coss:输出电容。Coss = CDS +CGD 。
Crss:反向传输电容。
Crss = CGD 。
MOSFET之感生电容被大多数制造厂商分成输入电容,输出电容以及反馈电容。所引述的值是在漏源电压为某固定值的情况下。此些电容随漏源电压的变化而变化。电容数值的作用是有限的。输入电容值只给出一个大概的驱动电路所需的充电说明。而栅极充电信息更为有用。它表明为达到一个特定的栅源电压栅极所必须充的电量。
在应用过程中,以下几个特性是经常需要考虑的:
1、V(BR)DSS的正温度系数特性。这一有异于双极型器件的特性使得其在正常工作温度升高后变得更可靠。但也需要留意其在低温冷启机时的可靠性。
2、V(GS)th的负温度系数特性。栅极门槛电位随着结温的升高会有一定的减小。一些辐射也会使得此门槛电位减小,甚至可能低于0电位。这一特性需要工程师注意MOSFET在此些情况下的干扰误触发,尤其是低门槛电位的MOSFET应用。因这一特性,有时需要将栅极驱动的关闭电位设计成负值(指N型,P型类推)以避免干扰误触发。
3、VDSon/RDSon的正温度系数特性。VDSon/RDSon随着结温的升高而略有增大的特性使得MOSFET的直接并联使用变得可能。双极型器件在此方面恰好相反,故其并联使用变得相当复杂化。RDSon也会随着ID的增大而略有增大,这一特性以及结和面RDSon正温度特性使得MOSFET避免了象双极型器件那样的二次击穿。 但要注意此特性效果相当有限,在并联使用、推挽使用或其它应用时不可完全依赖此特性的自我调节,仍需要一些根本措施。 这一特性也说明了导通损耗会在高温时变得更大。故在损耗计算时应特别留意参数的选择。
4、ID的负温度系数特性。ID会随着结温度升高而有相当大的减额。这一特性使得在设计时往往需要考虑的是其在高温时的ID参数。
5、雪崩能力IER/EAS的负温度系数特性。结温度升高后,虽然会使得MOSFET具有更大的V(BR)DSS,但是要注意EAS会有相当大的减额。也就是说高温条件下其承受雪崩的能力相对于常温而言要弱很多。
6、MOSFET的体内寄生二极管导通能力及反向恢复表现并不比普通二极管好。在设计中并不期望利用其作为回路主要的电流载体。往往会串接阻拦二极管使体内寄生二极管无效,并通过额外并联二极管构成回路电流载体。但在同步整流等短时间导通或一些小电流要求的情况下是可以考虑将其作为载体的。
7、漏极电位的快速上升有可能会发生栅极驱动的假触发现象(spurious-trigger)。故在很大的dVDS/dt应用场合(高频快速开关电路)需要考虑这方面的可能性。